生成式AI、大模型训练与智能终端的普及,正在引发全球存储芯片市场的“超级周期”,而传统存储架构已难以突破 “内存墙” 瓶颈,高带宽存储器(HBM)与先进封装技术的深度融合,成为破解AI算力提升难题的关键。
在这一产业浪潮中,封测作为半导体产业链最成熟的环节,率先承接国产替代与需求爆发的双重红利。2024年国内封测市场规模突破3000亿元,存储芯片封装作为其中增速最快的细分领域之一,正成为头部企业的必争之地。华天科技作为国内封测行业领军企业,凭借十余年技术积累与精准赛道布局,在存储芯片封装领域实现了从产能规模到技术突破的全面进阶,成为AI时代存储封装国产化的核心力量。

厚积薄发:华天科技十年深耕迎接AI驱动下的存储变局
在AI应用中,尤其是在高并发、实时性要求极高的场景里,存储芯片已经成为数据的“智能枢纽”。无论是训练AI模型所需的海量参数存储,还是推理过程中对数据流的快速响应,都要求存储芯片具备极高的吞吐速度和极低的延迟。例如,LPDDR5、HBM等高性能内存,以及基于3D NAND技术的高速固态硬盘(SSD),已成为AI服务器、高端显卡和旗舰智能终端的标配。
这不仅是对芯片设计本身的挑战,更是对封装技术的极限考验。如何在有限的物理空间内集成更多的存储单元?如何确保数十亿甚至上百亿个晶体管在高速运行下的信号完整性和散热效率?如何将NAND闪存、DRAM、控制器等不同类型的芯片高效、可靠地堆叠、集成在一起?这些问题答案,都指向了先进的封装技术。华天科技洞悉这一趋势,早已将存储封装作为其技术发展的一大核心支柱,并逐步构建了覆盖全产品线的全栈能力。
目前,华天科技在存储芯片封装领域已形成“技术成熟、量产稳定、迭代高效”的发展格局,核心优势集中体现在量产经验、良率控制与项目落地能力三大维度,为承接AI及新兴领域的存储需求奠定基础。
量产能力方面,华天科技在存储芯片封装领域已经积累了10年的量产经验,在市场竞争中奠定了坚实的基础。十年里,华天科技不断优化封装工艺,提升生产效率,积累了大量的技术经验和生产数据。目前,华天科技的存储封装+OS量产良率已经超过了99.95%,这一卓越的良率水平不仅体现了华天科技在封装工艺控制方面的高超能力,也意味着其能够为客户提供高质量、高可靠性的存储芯片封装产品。高良率的实现得益于华天科技在设备管理、原材料采购、生产流程优化以及质量检测等环节的严格把控,确保了每一个封装环节都能达到高标准的质量要求。
为应对存储技术的快速迭代,华天科技保持高强度的项目研发节奏,每年超过200件存储新项目开案,包括DDR4/DDR5、LPDDR4X/LPDDR5X、SSD/eSSD、eMMC、UFS2.2/UFS3.1/UFS4.1、MCP/eMCP/uMCP5、ePoP/nPoP/uPoP、Micro SD等主流存储产品,覆盖了从移动终端(如智能手机、平板电脑)到数据中心服务器,再到新兴的汽车电子与物联网设备的广阔应用场景。多样化项目的淬炼,使得华天科技能够灵活应对不同客户的定制化需求,形成了以市场为导向的快速技术响应能力。
具体来看在封装产品与工艺方面,华天科技已实现多类型存储封装的规模化量产,包括DDR5(wBGA封装)、LPDDR5X(ODP封装)、SSD(ODP/HDP封装)、eSSD(1C+32NAND集成)、eMMC(1C+4NAND集成)、UFS4.1(1C+8NAND集成)、uMCP (1C+8NAND+8LP5集成)等。
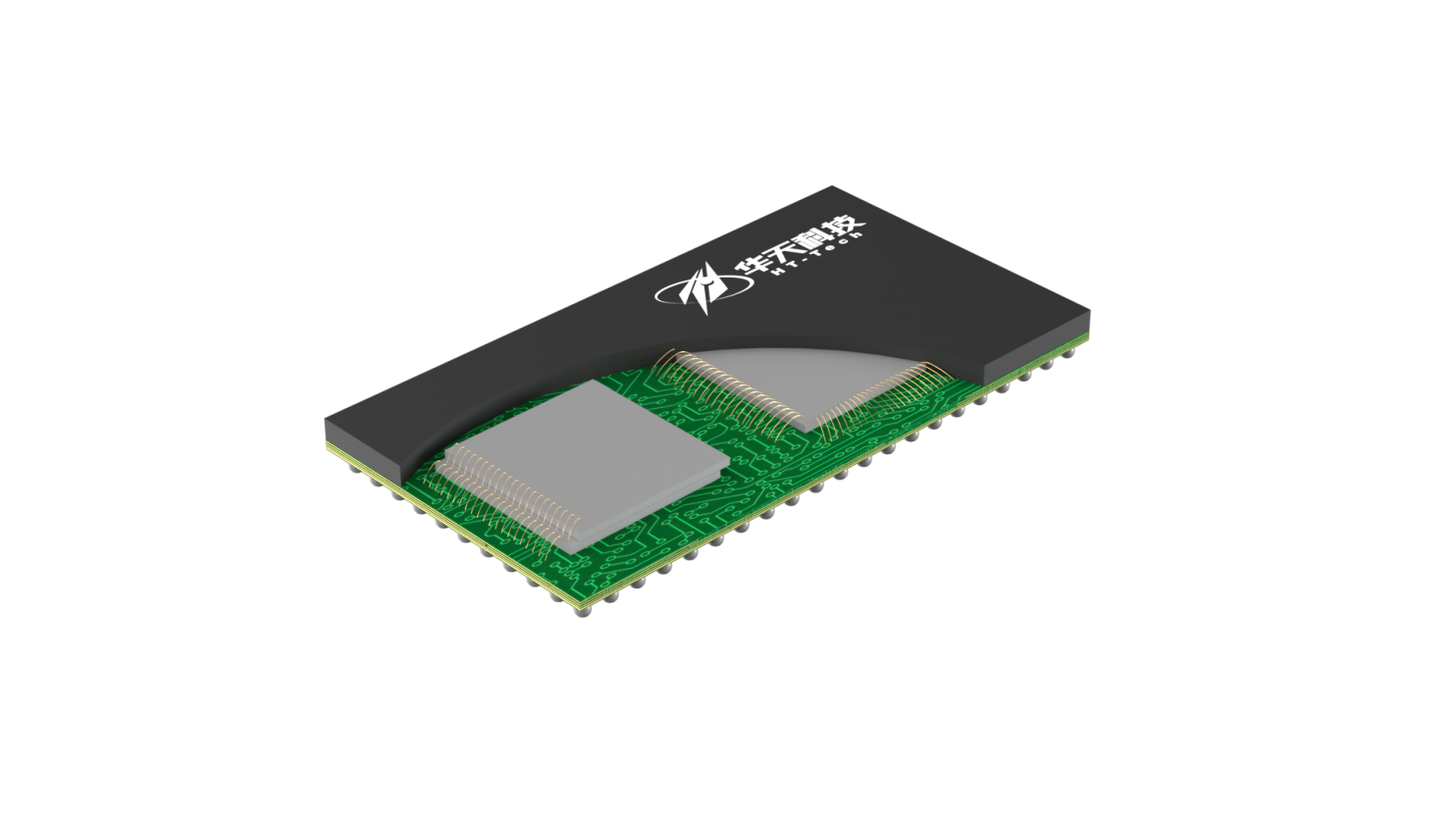
在细分存储品类上,DRAM领域已掌握LPDDR3/4/4X、245/315/496球LPDDR5/5X、wBGA DDR4/5的全流程封装技术,适配1y/1z nm、1ɑ/1β nm工艺节点;NAND Flash领域覆盖eMMC、UFS2.2/3.1/4.1(FC主控)、SSD、Micro SD,车载eMMC、eSSD等全系列产品,可适配128/176/232/300+层TLC/QLC存储;MCP领域则实现MCP、eMCP、uPoP (LP5+UFS3.1)、uMCP (LP5+UFS4)、电磁屏蔽uMCP等产品的量产,满足消费电子、汽车等多领域的复合型存储需求。
随着存储封装需求迅速攀升,华天科技正不断加大研发投入,华天科技除了继续在DDR/LPDDR/uPoP、SSD/eSSD、eMCP/uMCP、eMMC/UFS 等已量产主流存储产品进行技术精进迭代以保持技术领先外,同时积极布局了2.5D/3D存储封装,存内计算PIM封装,以及新型非易失性存储器封装等前沿技术,并有部分产品已落地量产。华天科技还逐步在向更尖端的GDDR和HBM、3D DRAM封装等领域进军,逐步构建一个完整的技术矩阵。
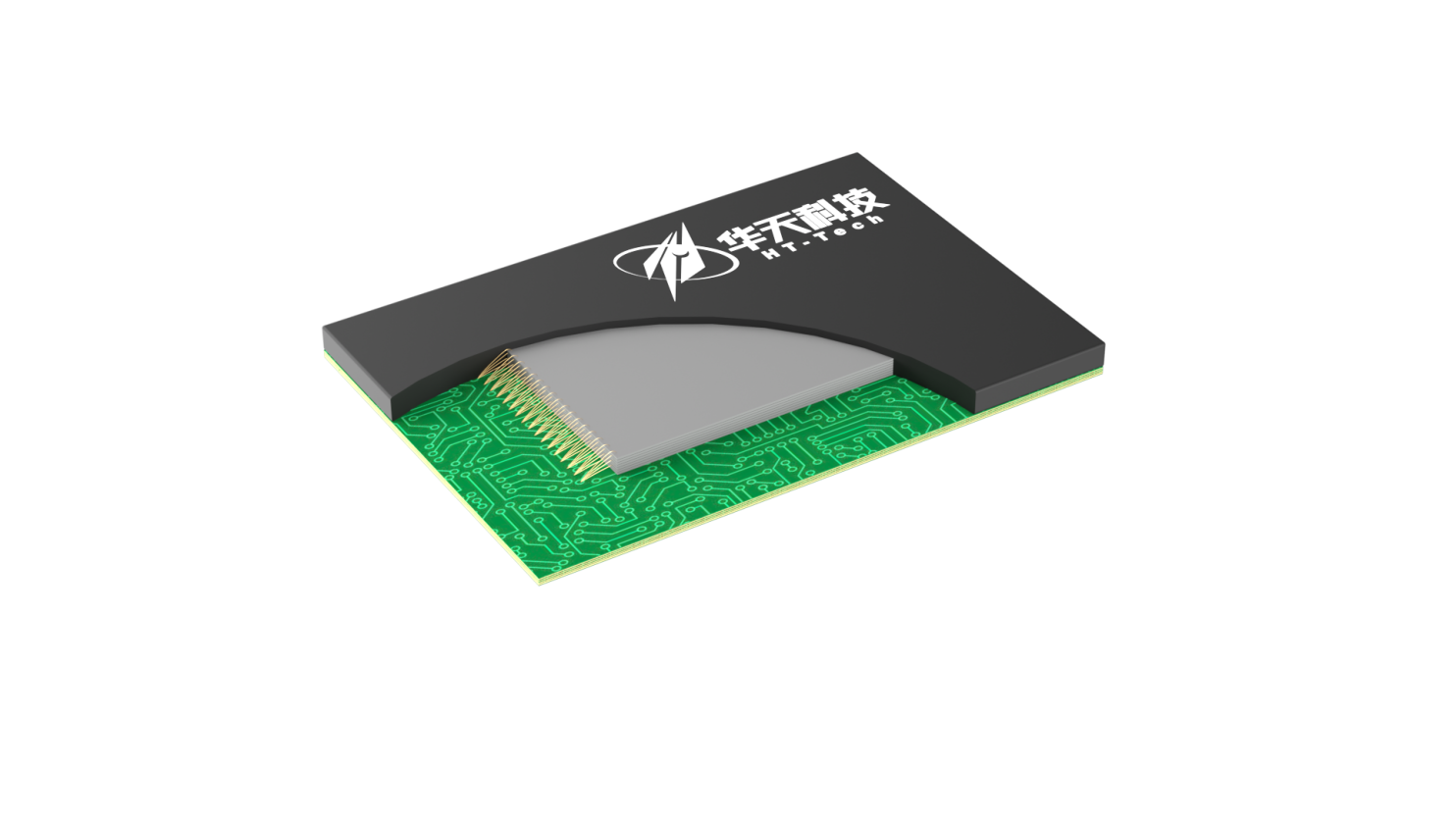
HBM被称为“AI的终极内存解决方案”,它通过2.5D/3D集成技术,将多颗DRAM芯片与处理器(如GPU)在硅中介层上并肩排列或垂直堆叠,实现了远超传统封装的内存带宽。这无疑是AI训练集群和高端显卡最渴求的技术。华天科技在此领域的研发,是其向全球封装技术第一梯队发起冲击的关键一步。
技术图谱:华天科技存储封装全品类产品与关键技术拆解
目前华天科技的产品与技术版图构建了NAND Flash、DRAM、MCP三大类存储芯片的封装体系,覆盖基础消费级、集成型、高性能存储等市场主流需求,形成“产品可量产、技术可落地、场景可覆盖”的完整体系。
NAND Flash封装:高密度与微型化双突破,覆盖多场景存储需求
NAND Flash作为消费电子、数据中心的核心存储载体,华天科技在此领域已形成“SSD/eSSD+eMMC/UFS+Micro SD”的全产品矩阵,技术亮点集中于超高芯片堆叠密度、极致微型化设计与多场景适配性:
3D NAND-SSD/eSSD:突破多层芯片堆叠技术,支持1D/2D/4D/8D/16D/32D全系列芯片层叠(最高32层),适配128/232层3D NAND(TLC/QLC)工艺,可在12×18mm的FBGA132封装尺寸内实现64GB~2TB存储容量,且通过优化基板层数与芯片厚度,将封装厚度控制在1.4mm(SSD)、1.6mm(eSSD)以内,满足超薄笔记本、AI 终端的空间需求;带散热片的eSSD产品进一步优化热管理,散热片厚度仅0.13mm,可适配高端服务器的高负荷运行场景。
eMMC/UFS:聚焦消费电子主流需求,eMMC采用“1控制器+1/2/4颗NAND”的集成方案,UFS支持“1控制器+2/4/8颗NAND”的灵活配置,均采用FBGA153封装(11.5×13mm),球径0.30mm、球距0.50mm的微型化互连设计,且UFS创新性采用“WB+FC Hybrid结构”,兼顾成本与性能,存储容量覆盖64GB~1TB,适配智能手机、物联网设备的中高端存储需求。
Micro SD卡:以“极致超薄+特种工艺”突破微型存储瓶颈,采用LGA8封装,通过45μm超薄芯片、20/10μm DAF胶层设计,将封装厚度控制在0.8mm以内;同时集成异型塑封、激光切割、斜刀切割等特种工艺,解决传统SD卡的边缘开裂等问题,适配232层3D NAND(TLC)工艺,容量达64GB~1TB,且支持黑白盖印、彩色喷印的定制化外观,满足消费电子的个性化需求。
DRAM封装:低功耗与高带宽兼顾,适配高性能计算场景
DRAM封装聚焦“低功耗(LPDDR)+高性能(DDR4/5)”两大方向,技术亮点体现在精细化工艺控制、高兼容性与高速传输能力:
LPDDR系列:针对移动设备低功耗需求,LPDDR4X采用FBGA200封装,支持2D/4D/8D芯片层叠,适配1y nm(14~16nm)工艺,容量 2GB~16GB;LPDDR5进一步升级为BGA315/496/245封装,通过50μm FOW Film、45μm线弧高度的精细化工艺,降低信号传输损耗,且支持8层堆叠(8D),容量8GB~16GB,可直接适配AI手机、平板的高性能内存需求。
FC DDR/wBGA DDR系列:面向高端服务器与PC,FC DDR采用Cu Pillar Bump(铜柱凸块)技术,通过倒装焊工艺减少信号延迟,FBGA78/96/82/106封装适配DDR4/5全系列,塑封采用Transfer(MUF)工艺,确保长期稳定性;wBGA DDR则以“晶圆级封装+引线键合”平衡成本与性能,适配1x nm(16~19nm)工艺,容量4Gb~16Gb,为中高端 PC、工业控制设备提供高性价比内存封装方案。
MCP 类封装:异构集成突破,满足复合型存储需求
MCP(多芯片封装)通过“DRAM+NAND Flash”的异构集成,实现“内存+存储”一体化,技术亮点在于高集成度、厚度控制与场景定制化:
uMCP/uMCP/eMCP:uMCP采用FBGA162封装,集成1颗LPDDR2与1颗NAND,适配38nm+32nm工艺,容量1GB+2GB,满足入门级消费电子需求;uMCP升级为FBGA297封装,支持8颗LPDDR5与8颗NAND堆叠,适配1α+268L TLC工艺,容量12GB+512GB/1TB,且通过“瀑布线”键合技术解决多层芯片信号干扰问题;eMCP则聚焦国产化适配,采用国产控制器,集成“1控制器+2/4颗LPDDR+1/2颗NAND”,封装厚度仅0.92/1.09mm,满足国产消费电子的复合型存储需求。
uPoP:针对高端堆叠场景,uPoP采用“13×14mm(LPDDR5)+11.5×13mm(UFS3.1)”的组合封装,集成UFS3.1(1控制器+8颗 NAND)与 LPDDR5(8颗DRAM),适配236层3D NAND(TLC)工艺,容量8GB+512GB/1TB,核心依托TMV技术实现上下层封装精准互连,解决传统PoP的厚度与可靠性痛点,适配折叠屏手机、AI可穿戴设备的空间敏感需求。
值得一提的是,TMV(Through Molding Via,塑封体激光开孔)技术作为华天科技uPoP/PoP堆叠封装的核心支撑,通过“高精度工艺+ 精细化控制” 解决 uPoP 等产品的互连难题,在实现高精度互连(中介层)方案、超低Mold Clearance、超低弧高和TMV激光烧球精度控制等方面具备显著优势。
结语
AI的浪潮正拍打着信息技术产业的每一个角落,而存储芯片,作为数据的承载者,正从幕后走向台前。华天科技凭借其在存储芯片封装领域的丰富量产经验、卓越的良率表现、多样化的产品封装能力、强大的技术创新与研发实力以及先进的封装设备与自动化生产,已经在市场竞争中占据了重要地位。至今为止,华天科技在存储芯片封装的规模体量、客户群体、产品技术布局上均已处于国内领先地位,并且还将继续保持领先。
未来,华天科技将继续拓展先进封装技术、提升封装智能化水平、加强与产业链上下游合作以及拓展国际市场与品牌建设,不断提升其在存储芯片封装领域的核心竞争力。华天科技将致力于以卓越的产品和服务推动微电子产业的发展,朝着打造中国封测行业第一品牌的目标奋勇前行,为全球存储芯片市场的发展注入新的活力,助力AI技术在各个领域的广泛应用和创新发展。