——微米尺度上精准“堆叠”,成就芯片性能的宏大飞跃
随着电子设备向着小型化、轻量化、高性能化及低成本方向飞速发展,集成电路芯片尺寸持续缩小,对封装技术提出了前所未有的挑战。能够实现高密度互联的凸点加工工艺脱颖而出,而电镀技术,正是塑造这些精密金属结构的核心工艺。从Flip Chip到3D堆叠,几乎所有先进封装形式都离不开它的身影。
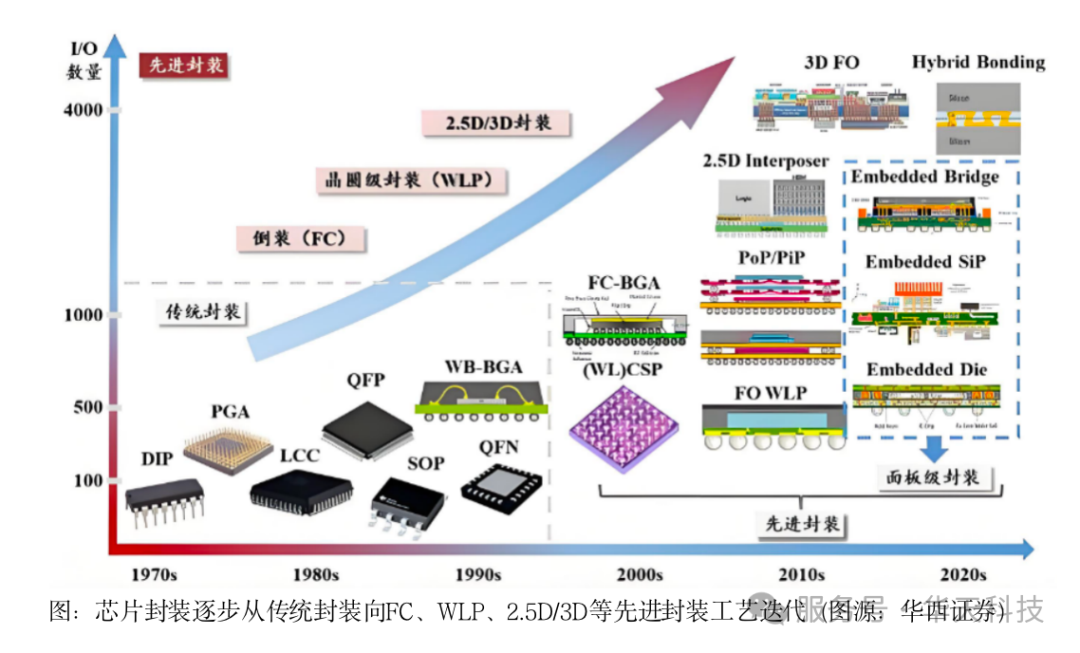
一、Flip Chip封装:坚固的“桥梁”与“基石”
在Flip Chip(倒装芯片)中,电镀扮演了两个关键角色:
1、打造“可焊”的基板:在基板焊盘上,通过电镀形成一层焊料可浸润的金属表面(如化学镍金),这确保了芯片上的凸块能够通过回流焊,牢固地“站立”在基板之上,构成可靠的连接。
2、构筑“铜柱”互联:直接在芯片上电镀出坚实的铜柱,作为连接芯片与外部世界的“金属桥梁”。这种结构能实现更小的节距、更高的互联密度和更优的电性能。
二、晶圆凸块:告别“飞线”,迎接“点焊”
传统的Wire Bonding(打线连接)如同用“飞线”连接芯片,而Bumping(凸块技术)则像精准的“点焊”。
通过在芯片的铝垫电极上直接电镀出铜柱、锡球或金凸块,它彻底取代了繁琐的打线。这不仅让互联速度更快、效率更高,更使得封装体积朝着“轻薄短小”迈出了革命性的一步。
三、晶圆级封装:芯片表面的“规划大师”
晶圆级封装直接在整片晶圆上进行加工,其中电镀技术至关重要:
1、重布线层:芯片的“内部立交”:通过电镀铜,在晶圆表面重新规划电路走线,将原本拥挤在芯片边缘的I/O焊盘,巧妙地重新分布到整个芯片表面。这极大地提升了芯片设计的灵活性。
2、凸块下金属层:牢固的“地基”:在铝焊盘上,先用电镀制作一层凸块下金属层。它如同高楼的地基,提供了良好的粘附性、阻挡性和导电性,确保上方的凸块坚如磐石。
四、2.5D/3D封装:垂直世界的“建造者”
当芯片的集成从平面走向立体,电镀技术更是大放异彩:
1、中介层:硅中的“交通枢纽”——在2.5D封装中,中介层承载着大量的硅通孔和重布线层。电镀技术负责构建这个复杂的立体交通网络,实现上下层芯片之间高效的数据传输。
2、硅通孔:贯穿楼层的“高速电梯”——这是3D封装的标志性技术。通过在硅片上刻蚀出深孔并用电镀铜完美填充,形成了垂直方向的互联通道,极大缩短了互联距离,提升了整体性能。
电镀工艺:微观世界的精准“雕刻”
下面以Bumping中的电镀为例介绍封装行业的电镀工艺。在Bumping工艺中,电镀的核心任务是在晶圆上“长出”尺寸精确、形状完美的金属凸块。这个过程就像一个在微观世界里进行的精准“堆叠”游戏,其背后的科学原理,主要基于经典的法拉第电解定律。
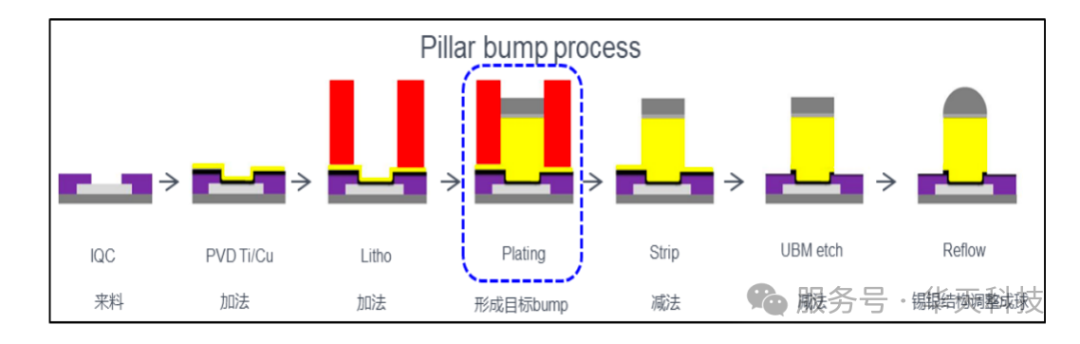
电镀原理——法拉第第一定律
对于单个电镀反应池,其基本规律可以概括为:阴极上析出的金属量,与通过的电流大小和通电时间成正比。用公式表示就是:M = K × I × t(其中M为金属质量,K为常数,I为电流,t为时间)。
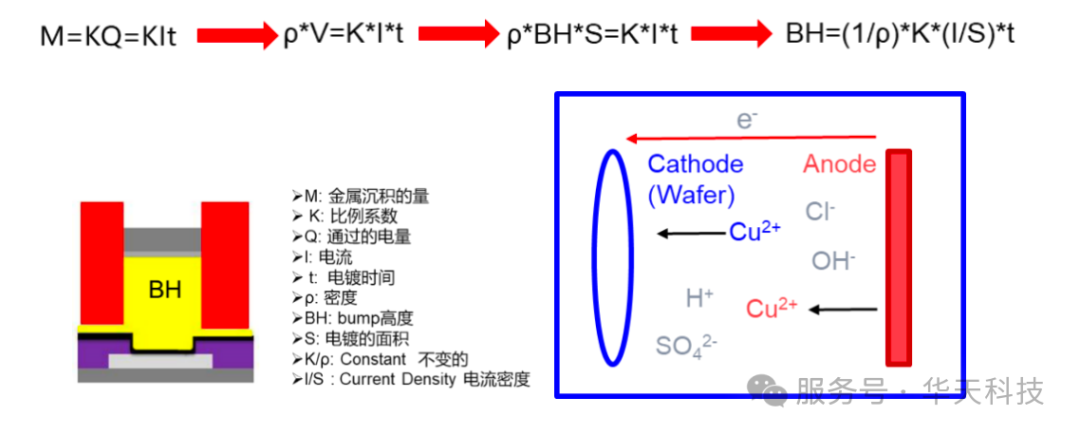
控制凸块高度的“双旋钮”:电流与时间
映射到Bumping工艺上,这就意味着:
电流密度:相当于控制金属离子沉积的“速度旋钮”。
电镀时间:相当于控制沉积过程的“时长旋钮”。
通过精确调控电流密度(金属离子沉积的“速度旋钮”)和电镀时间(沉积过程的“时长旋钮”),工程师就能精准控制每个微凸块的最终高度,确保成千上万的凸块都具有均一、可靠的尺寸。
电镀池内的微观“搬运”之旅
那么,电流是如何驱动金属“生长”在晶圆上的呢?这背后是一场生动的电化学“微电影”:
1、阳极的“奉献”:在电镀液中,可溶性的阳极(例如磷铜球)在电流作用下,会不断被氧化,释放出金属离子,补充到溶液中,如同为建筑持续供应“砖块”。
2、离子的“迁徙”:在电场力的驱动下,这些带正电的金属离子向带负电的阴极(即晶圆)移动。
3、阴极的“结晶”:当金属离子到达晶圆表面时,会获得电子并被还原成金属原子,逐层地、有序地沉积在特定的“种子层”上,最终“堆叠”成我们设计好的凸块结构。
看不见的“配方”:电镀液与添加剂
要实现高质量的电镀,光有电流和金属还远远不够。电镀液本身的“配方”至关重要,它通常包含:
金属盐:如硫酸铜,是提供“建筑原料”的主盐。
电解质:如硫酸,用于提高溶液导电性,保证电流畅通。
添加剂:这才是电镀工艺的“灵魂”。它们微量但作用巨大:
加速剂:加快材料凹陷处强力促进沉积。
抑制剂:能适度减缓凸块顶部的沉积速度。
整平剂:能促进凹陷处填充,确保凸块形状饱满、平整。
通过这些添加剂的协同作用,我们才能克服表面张力和电流分布不均带来的挑战,在微米尺度上“雕刻”出完美无瑕的金属凸块。
华天科技在先进封装电镀领域的布局与突破
作为中国领先的半导体封装测试企业,华天科技深刻把握电镀工艺在先进封装中的核心地位,并将其视为实现高密度、高性能互联的关键技术。公司近年来持续加大在晶圆级封装、TSV、Fan-Out等领域的电镀工艺研发,深耕fine pitch高密度电镀及深孔填充等关键技术,具备成熟的量产能力。
目前,华天科技致力于Flip Chip、晶圆级封装、2.5D/3D等先进封装产品中的电镀工艺进行研发攻坚,并不断取得突破。新的产品在应用端覆盖CIS、显示驱动、射频、存储等多个重要市场,根据国内外客户的需求提供高性能、高可靠性的封装解决方案。
面向未来,华天科技将继续深耕先进封装技术,推动电镀工艺向密度更高、高度均匀性更好,可靠性更稳定方向发展,持续强化在三维集成和系统级封装方面的技术布局,为中国半导体产业链的完善与自主可控贡献“华天力量”。









